Моделирование производства кристаллов бис и сис
3. Моделирование производства кристаллов БИС и СИС. Методы и алгоритмы моделирования базовых технологических операций
3.1. Изоляция элементов БИС и СИС, модели процессов термического окисления
Роль оксидных плёнок кремния в технологии БИС и СИС. Технология полупроводниковых структур с комбинированной изоляцией элементов. VIP технология. Технология структур с полной диэлектрической изоляцией. Структуры КНД. Использование метода глубокой имплантации ионов кислорода, горизонтального наращивания локальных эпитаксиальных слоёв, окисления пористого кремния, рекристаллизации аморфного или поликристаллического кремния при изоляции карманов в твёрдотельных структурах БИС и СИС.
Назначение моделирования в проектировании технологии и кристаллов БИС и СИС.
Модели процессов термического окисления кремния и диффузии. Специальные методы окисления. Перераспределение легирующих примесей на границе раздела фаз. Основные свойства формируемых плёнок оксида кремния. Заряд и напряжения в плёнках оксида кремния. Основы моделирования быстрого термического отжига.
Оксидные плёнки в составе БИС и СИС, в основном, выполняют функции маскирования с целью получения локальных активных областей кристалла. Другими словами, именно благодаря многим замечательным свойствам плёнок диоксида кремния удаётся реализовать достоинства кремния, как главного материала электронной техники. Например, на подложках из Ge и GaAs получить путём окисления исходной подложки защитные плёнки со стабильными свойствами не удаётся. Именно поэтому на основе Si в настоящее время изготавливается свыше 95% БИС и СИС.
Что касается защиты кристалла, то иногда защитные свойства плёнок SiO2 оказываются недостаточными и в этих случаях используют дополнительную защиту, например плёнками Si3N4 или Ta2O5. Вообще же оксидные плёнки кремния входят в состав практически любой базовой ячейки полупроводниковой структуры, в том числе дискретных элементов.
Кроме того, плёнки SiO2 применяют для получения высококачественной электрической изоляции элементов БИС и СИС между собой.
На практике широко используется технология полупроводниковых структур с комбинированной изоляцией элементов, получивших название структуры типа «Изопланар».
В качестве исходных используют слаболегированные подложки КДБ 10, ориентированные в плоскости (111) или (100).
После химической обработки и окисления проводят литографию. При этом отказ от контактной литографии к переход к проекционной литографии обозначал переход от технологии «Изопланар-1» к технологии «Изопланар-2».
Рекомендуемые материалы
Далее методами ионного легирования во вскрытые окна вводят примесь мышьяка или сурьмы. Формируемый таким образом скрытый слой служит в качестве сильнолегированной области коллектора для уменьшения его сопротивления. Затем выращивается эпитаксиальный слой обычно p-типа. После контроля параметров ЭС выращивают термический слой SiO2 толщиной 50 нм, а затем слой Si3N4, имеющий низкую скорость окисления, что позволяет использовать его в качестве маски для последующего локального окисления.
По двухслойной маске проводят фотолитографию, вскрывают области будущей диэлектрической изоляции и, используя в качестве маски фоторезист, проводя последовательное травление слоёв нитрида, оксида и части эпитаксиального слоя. Метод травления может быть изотропный или анизотропный – для подложек с ориентацией (100).
Непосредственно перед глубоким локальным окислением проводят ионное внедрение бора для создания p+ областей для предотвращения инверсии слаболегированной подложки и образования паразитных связей между соседними элементами.
После окончания окисления будет сформирован диоксид кремния толщиной hSiO2 = 2,12 *0,5 hЭС.
Другое отличие структур «Изопланар-1» и «Изопланар-2» состоит в том, что в первом случае эмиттерные области формировались как вписанные в базу, а во втором – создавался пристеночный эмиттер, что почти в 2 раза уменьшило площадь прибора.
VIP технология основана на использовании анизотропного травления для изоляции с помощью V- образных канавок. Поэтому подложки должны иметь ориентацию в плоскости (100). Огранка канавок происходит плоскостями (111). Угол между плоскостями (100) и (111) составляет около 55о. Т.о. угол J =35о.
Помимо рассмотренных процессов создания изоляции элементов разработаны и используются для ряда изделий, например микромощных БИС и СИС, технологические методы изготовления структур с полной диэлектрической изоляцией.
Среди общих достоинств методов этой группы можно назвать:
§ Снижение паразитных ёмкостей и токов утечки,
§ Предотвращение эффекта «защёлкивания» и возникновения паразитных транзисторов.
ЭПИК процесс, разработан фирмой Motorola. Согласно этому процессу исходной подложкой служит кремний n- типа с r = 0,25 Ом×см. На нём создают n+ слой эпитаксией или диффузией. Кремний травят на глубину 20-30 мкм и окисляют. Толщина SiO2 не должна превышать 4 мкм, что связано с различием ТКЛР.
Далее на окисленную профилированную поверхность осаждают поликристаллический кремний их ПГС SiH4 + H2 при Т = 650оС или SiCl4 + H2 при концентрации SiCl4 более 1,5%. Толщина поликремния составляет 300 мкм и более. Возможно чередование слоёв поликремния и SiO2, что позволяет снизить ёмкость создаваемой подложки.
Затем монокристаллическая подложка удаляется методами шлифования, травления, химико-механическим полированием вплоть до поликремниевых канавок. Затем формируют активные области в изолированном кармане.
Существует модифицированный вариант ЭПИК процесса, в котором в качестве исходной подложки используется n+ Si. После создания профилированной поверхности и её окисления осаждают слой поликремния и удаляют исходную подложку. Затем стравливают n+ слой до толщины 10-12 мкм и локально выращивают эпитаксиальный слой n типа.
Другой (более важный) вариант ЭПИК процесса называют «позитивным». Тогда исходная n+ подожка в этом случае окисляется и без формирования канавок на её поверхность наносят слой поликремния. Слой исходного n+ Si стравливается до толщины 8-10 мкм и на нём выращивают слаболегированный эпитаксиальный слой n типа. Структуру вновь окисляют и вновь осаждают поликремний на всю глубину канавок. Удалив поликремний с поверхности n+ - n карманов поверхность окисляют и традиционными методами создают активные области БИС.
Структуры КНД. Наряду с несомненными достоинствами эти структуры имеют существенные недостатки. В частности, существенные токи утечки обусловлены чрезвычайно высокой плотностью поверхностных состояний на границе Si / Al2О3.
Это определило поиск других способов формирования КНД, причём не только с использованием объёмного диэлектрика, каким является сапфир или кварц, но и тонких слоёв оксида и нитрида. Среди этих методов известны следующие:

На рисунке 3.1 представлены основные операции LOCOS процесса, актуального для МОП БИС.
Сформированные плёнки диоксида кремния имеют встроенный положительный заряд плотностью до 1013 см-2. Для измерения его величины использую метод вольт-фарадных характеристик.
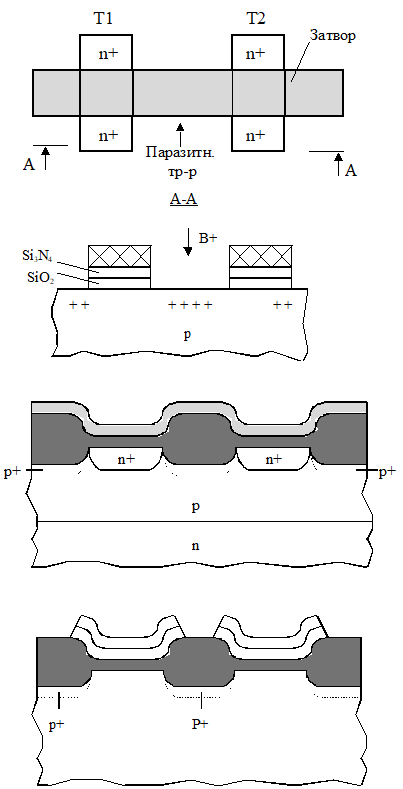 |
Рисунок 3.1 – Последовательность основных операций
в LOCOS процессе
3.2. Основы моделирования процессов ионного легирования
Разновидности процессов и модели технологии ионного легирования. Поколения программ технологического моделирования. Моделирование процессов ионного легирования. Проекционная длина пробега ионов. Профили легирования имплантированных примесей. Модель Линхарда-Шарфа-Шиотта. Распределение Пирсона. Эффект каналирования. Последовательность расчета параметров процесса ионного легирования
Ионно-лучевой ускоритель состоит из следующих основных блоков; источника ионов, источника высокого напряжения, ускорительной трубки, магнитного сепаратора, системы фокусировки и сканирования пучка ионов, приемной камеры и вакуумной системы откачки.
Источник ионов предназначен для ионизации паров рабочего вещества и первичной фокусировки ионного пучка. Он представляет собой газоразрядную камеру, при поступлении газа или паров рабочего вещества в которую происходит ионизация молекул и атомов путем бомбардировки электронами, эмитируемыми термокатодом. Поперечное магнитное поле в разрядной камере, создаваемое магнитной системой, вызывает вращение движущихся в нем электронов по спирали, что увеличивает эффективность ионизации. В ионно-лучевых ускорителях типа «Везувий-3М» (рисунок 2.9) предусмотрены два источника ионов: для фосфора Иф и для бора Иб. Они различаются способом подачи вещества. В источник ионов бора поступает газ — трехфтористый бор ВF3 — из баллона с микронатекателем МН. Расход газа контролируется автоматически. В источник ионов фосфора подают пары фосфора, образующиеся в испарителе с нагревателем Н, в который загружают порошок красного фосфора. В процессе имплантации функционирует только один из ионных источников.
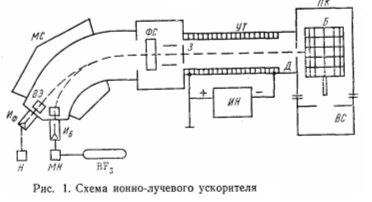
Рисунок 3.2 – Схема ионно-лучевого ускорителя
в установках типа «Везувий 3М»
Положительные ионы вытягиваются из разрядной камеры небольшим ускоряющим напряжением первой ступени—до 40 кВ, подаваемым на вытягивающий электрод ВЭ. Формирование ионного пучка производят с помощью магнитного сепаратора МС и системы фокусировки и сканирования ФС. Магнитный сепаратор предназначен для разделения пучка ионов в соответствии с их зарядом и массой, так как под действием силы Лоренца в области магнитного поля сепаратора ионы движутся по круговым траекториям, радиусы которых зависят от их массы M1, ускоряющего напряжения (U и магнитной индукции В:
 ,
,
где q—заряд иона.
После прохождения магнитного сепаратора ионы больших масс имеют более плавные траектории, ионы меньших масс — меньший радиус поворота и более резкое искривление траектории. Магнитная система сепаратора выполнена в виде постоянного магнита, для которого В=соnst, поэтому, чтобы вывести пучки ионов В+ и Р+ в систему фокусировки и сканирования, источники ионов бора и фосфора разделяют.
Система фокусировки и сканирования формирует ионный пучок и осуществляет его сканирование в вертикальной плоскости. В систему входит электростатическая фокусирующая линза и два электрода электростатического сканирования. Смещение S пучка в вертикальной плоскости прямо пропорционально напряжению Uc на электродах сканирования:


 ,
,
где l—длина сканирующего электрода; L—расстояние от центра сканирующего электрода до мишени; d — расстояние между электродами сканирования по вертикали; U — ускоряющее напряжение.
Между системой ФС и ускоряющей трубкой УТ находится заслонка З для автоматического перекрытия ионного пучка при наборе заданной дозы.
Ускорительная трубка состоит из последовательности изолированных электродов, между каждым из которых от источника высоковольтного питания ИН прикладывается напряжение до 20 кВ так, что крайние электроды имеют разность потенциалов около 200 кВ. Положительный пучок ионов ускоряется в направлении отрицательно смещенного электрода.
Приемная камера ПК служит для загрузки обрабатываемых полупроводниковых пластин, которые размещаются на кассете барабанного типа Б в несколько рядов. Вакуумная система ВС обеспечивает разрежение 2х10-3 Па. При облучении ионный пучок сканирует вдоль оси вращающейся кассеты Б, что обеспечивает высокую однородность легирования. Перед кассетой стоит прямоугольная диафрагма Д, которая задает высоту и ширину облучаемой области. Время облучения t(с) для набора дозы Q(Кл/м2) при плотности ионного тока j(А/м2) определяется соотношением

 ,
,
где a — выраженный в радианах угол, определяемый сектором окружности барабана, на который попадает ионный пучок, проходящий через диафрагму заданной ширины.
Сектор тем больше, чем шире диафрагма. Для набора малых доз ширину диафрагмы уменьшают, что ведет к уменьшению a и увеличению длительности облучения до нескольких минут, что, в свою очередь, улучшает точность контроля дозы.
Рабочие вещества для получения ионов могут находиться в газообразном, твердом и жидком состояниях, для получения ионов О+, N+,Ne+, Аr+, F+, Cl+ и т. п. используют соответствующий газ, поступающий в вакуумную камеру источника ионов через микронатекатель. Из других газообразных материалов следует отметить применение ВF3 для ионов В+, СО2 для ионов С+, Н2S для ионов S+. Широко применяют жидкие вещества, особенно хлориды ВСI3, ВВг3, РСI3, ССI4, SiС14, хорошо испаряющиеся при комнатной температуре. Наибольшие ионные токи обычно достигаются при употреблении твердых материалов в элементарном виде. Эти вещества требуют нагрева, чтобы получить достаточное давление паров: S и Р (красный) — 175°С, Аs—260°С, Zn, Se и Те—550°С, Мg и Sb—580°С. Могут быть использованы и другие вещества. Основное требование к ним – большое парциальное содержание легирующего элемента в парах. Вследствие выделения изотопной линии легирующего элемента в анализаторе масс в отличие от других методов легирования полупроводников к рабочим веществам не предъявляют жестких требований по чистоте.
При определении режимов ионной имплантации основными параметрами являются энергия ускоренных ионов и доза облучения. Ион с зарядом q(Кл) под действием разности потенциалов U(В) приобретает энергию Е (Дж):

 .
.
На практике принято, говоря об энергии ускоренных ионов, выражать её в электрон-вольтах (эВ) или килоэлектрон-вольтах (кэВ). Так как кратность ионизации обычно составляет n=1, 2 или З электрона, то заряд иона может изменяться от 1 до З е. В общем случае

 .
.
для обозначения кратности ионизации применяют символ «+», например 31Р+, З1Р++, З1Р+++. Числом 31 обозначена атомная масса иона фосфора. Иногда для имплантации используют не моноатомные ионы, а молекулярные, например 14N2+ — однократно ионизированная двухатомная молекула азота с атомной массой 14, молекулярной массой 2*14=28 или ВF2+ -- однократно ионизированная трехатомная молекула фторида бора. Молекулярные ионы, внедряясь в кристалл, обычно сразу распадаются на отдельные атомы. для подсчета энергии, которой будет обладать каждый атом с массой М1, входящий в ускоренный ион с молекулярной массой Ми , используют соотношение
Е1 =ЕМ1/Ми.
Доза облучения — это количество частиц, бомбардирующих единицу поверхности за данное время. Доза может не быть равной тому количеству ионов, которое осталось в кристалле после завершения процесса облучения, вследствие наличия явлений распыления и отражения. В большинстве случаев эти явления не оказывают заметного влияния на количество внедренных ионов. Доза облучения q(Кл/м2) определяется плотностью ионного тока j(А/м2) и длительностью облучения t (с):

 .
.
Практически плотность ионного тока выражают обычно в мкА/см2, поэтому дозу облучения выражают в мкКл/см2. Величина Q не отражает в явном виде числа примесных ионов, внедрённых в кристалл. Чтобы выразить дозу в количестве частиц, внедренных на единице поверхности (ион/м2), величину Q делят на заряд одного иона:

 .
.
Имея в виду, что e= 1,6x10-19 Кл, а Q имеет размерность мкКл/см2, доза облучения (ион/см2)

 .
.
Метод ионной имплантации является основным в планарной технологии, сочетающей загонку примеси в виде дозированного количества ионов и диффузионную разгонку. Совмещение ионной имплантации с планарной технологией облегчается применением тех же легирующих примесей и веществ для их получения, что и при диффузии; использованием тех же материалов для маскирования при таких же толщинах, что никак не влияет на процесс фотолитографии; возможностью управления дозами облучения в очень широких пределах (от 1010 до 1017 см-2) при высокой производительности.
Основные преимущества метода ионной имплантации, на которых базируется его использование в серийном производстве, состоят в точном контроле полного количества внедренной примеси и высокой однородности легирования по поверхности пластины. Неоднородность в распределении плотности внедренной примеси по пластине с диаметрами 100% мм составляет 1 % или менее при невоспроизводимости результатов от процесса к процессу в пределах 3%. Точность контроля на большинстве технологических операций полупроводникового производства не достигает 1—3% и колеблется в пределах 10—20%.
3.3. Моделирование процессов формирования конфигурации элементов
Модели процессов оптической литографии. Субтрактивный и аддитивный процессы. Параметры процесса. Последовательность расчета модели. Учёт второй координаты.
Моделирование процессов осаждения тонких пленок, в том числе металлических методами вакуумного испарения и магнетронного распыления, а также процессов их травления. Алгоритм модели струны. Граничные условия. Формируемые профили плёнок на подложках со сложным рельефом. Применение программ технологического моделирования (SAMPLE и др.).
Фотолитография - это процесс формирования на поверхности пластины с помощью светочувствительного химически стойкого материала рельефного покрытия с изображением элементов схемы и последующего переноса изображения на подложку. Химические светочувствительные светосистемы, в которых под действием излучения определенного спектрального состава протекают фотохимические процессы, получили название фоторезистов. Фоторезисты, у которых растворимость освещенного (экспонированного) участка уменьшается, называются позитивными, а растворимость которых после облучения возрастает - негативными.
Экспонирование фоторезистов производят через фотомаску (фотошаблон) с изображением элементов схемы. После обработки фоторезиста в растворе, удаляющем экспонированные участки (проявитель) на поверхности пластины образуется рельефное изображение, устойчивое к воздействию агрессивных сред даже при нагревании. Полимерные системы, из которых формируют фоторезисты, могут быть чувствительны не только к видимому или УФ-излучению, но и к потоку электронов (электронорезисты) или к рентгеновскому излучению (рентгенорезисты). Процесс литографии соответственно называется электронолитография и рентгенолитография. Схема процесса фотолитографии приведена на рисунке 3.3. Виды литографических процессов показаны на рисунке 3.4.
Рассмотрим фотохимические процессы в фоторезистах. Главным свойством фотохимических превращений является то, что поглащенный фотон действует селективно, возбуждая лишь отдельную молекулу органической системы и не затрагивая остальных. Кинетику фотохимических реакций можно представить как поглащение фотона молекулой, переходящей в активное состояние; первичные фотохимические процессы с участием активированных молекул; вторичные ("темновые") процессы между молекулярными комплексами образовавшимися в ходе первичных процессов.
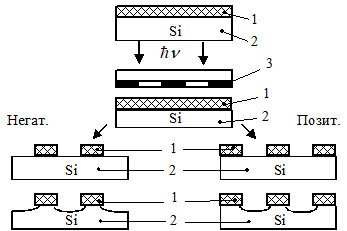
| 1-фоторезист; 2-подложка; 3-фотошаблон Рисунок 3.3 – Схема процесса фотолитографии |
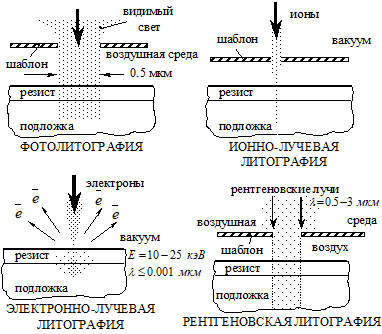
| Рисунок 3.4 – Виды литографических процессов |
Для оценки эффективности фотохимических взаимодействий вводится понятие квантового выхода У, который определяется как отношение числа прореагированных молекул (N) к числу поглащенных фотонов ( ):
):
 , (3.1)
, (3.1)
где  - количество поглощенной световой энергии;
- количество поглощенной световой энергии;
 - энергия фотона;
- энергия фотона;
 .
.
Различают несколько типов фотохимических реакций:
1. Реакция фотолиза - возбуждение молекул фотоном с последующим распадом на активные частицы:

 ;
;
2. Реакции фотоперегруппировки - перестановка атомов (или радикалов) в главной цепи молекулы под действием света, чаще всего поворот одной группы атомов относительно другой:

3. Реакция фотоприсоединения - присоединении активированной молекулой другой молекулы или молекул:
 - фотодимеризация;
- фотодимеризация;
 - фотогидролиз;
- фотогидролиз;
 - фотоокисление.
- фотоокисление.
4. Реакции фотопереноса электрона - отщепление электрона у молекулы, возбужденной фотоном:
 ;
;
 .
.
Часто различные типы фотохимических реакций протекают параллельно в одной органической системе. Химический процесс, стимулированный светом, приводит к образованию радикалов, химическая активность которых достаточна для протекания вторичных процессов.
Свойства (параметры) фоторезистов:
1. светочувствительность - величина, обратная экспозиции, требуемой для перевода фоторезиста в растворимое (позитивный процесс) или в нерастворимое (негативный процесс) состояние. Фоторезист должен обладать максимальной светочувствительностью в требуемом диапазоне длин волн. Большинство фоторезистов имеют максимальную чувствительность в ближней УФ-области спектра 500-550 нм (~0.5 мкм);
2. разрешающая способность - максимально возможное число сплош-ных контрастно различимых полос фоторезиста, разделенных промежутками равной ширины, размещенных на одном мм;
3. стойкость к воздействию агрессивных сред. Этот параметр трудно оценить количественно. Иногда эта величина пропорциональна времени отслаивания пленки фоторезиста при обработке в стандартном травителе (сек);
4. стабильность эксплуатационных характеристик фоторезиста во времени определяется их неизменностью при определенных условиях хранения и использования.
Требования к фоторезистам:
1. высокая светочувствительность в требуемом диапазоне Л;
2. высокая разрешающая способность 1000-2000 линий/мм при толщине фоторезиста - 0.1 мкм;
3. высокая адгезия к нижележащим слоям;
4. высокая контрастность;
5. устойчивость в химически агрессивных средах;
6. однородность и стабильность свойств;
7. отсутствие загрязнений продуктами химических превращений.
Основные фоторезисты: ФП - 333; ФП - 383М; ФП - РН - 7; ФН - 106; ФН - 108; ФН-11.
Нанесение пленок в условиях вакуума представляет собой физическое осаждение вещества из газовой фазы. Газовая фаза состоит из атомов и молекул осаждаемого вещества. Необходимо учитывать присутствие атомов и молекул остаточных газов. Сущность процесса термического испарения заключается в нагреве вещества в высоком вакууме ~10-4 - 10-6 Па. до температуры, когда давление его собственных паров на несколько порядков превышает давление остаточных газов. При этом атомы испаренного вещества распространяются прямолинейно, т.к. длина свободного пробега значительно превышает расстояние "источник-подложка".
В соответствии с физическими процессами, протекающими при термическом испарении материалов в вакууме, можно выделить три основных фазы (области) протекания:
- область образования паров (образование атомарно-молекулярного потока);
- область переноса паров (пролет частиц к подложке);
- область конденсации паров (конденсация паров).
Рассмотрим эти области. В области образования потока происходит испарение материала. Молекулы, обладающие наибольшей кинетической энергией при данной температуре, преодолевают силы молекулярного, поверхностного натяжения и отрываются от поверхности расплава. Температура испарения - это температура, при которой давление равновесного пара испаренного вещества достигнет  . Обычно при нагреве вещество сначала плавится, а затем начинает испаряться. Однако некоторые материалы (Sb, Mg, Ti, Mo) имеют температуру испарения ниже температуры плавления.
. Обычно при нагреве вещество сначала плавится, а затем начинает испаряться. Однако некоторые материалы (Sb, Mg, Ti, Mo) имеют температуру испарения ниже температуры плавления.
Такие материалы легко испаряются в вакууме из твердого состояния. Такое явление называют сублимацией. Обычно вещества переходят в пар при любой температуре выше абсолютного нуля, но для увеличения интенсивности парообразования необходим нагрев вещества. С ростом температуры возрастает средняя кинетическая энергия атомов и увеличивается вероятность разрывов межатомных связей. Удельная скорость испарения (интенсивность испарения), равная количеству граммов вещества, испаренного за одну секунду с площади  определяется:
определяется:
 , (3.2)
, (3.2)
где  - давление насыщенного пара испаряемого вещества;
- давление насыщенного пара испаряемого вещества;
 - молекулярная масса вещества [г/моль];
- молекулярная масса вещества [г/моль];
 - температура вещества (К).
- температура вещества (К).
Величина  сильно зависит от
сильно зависит от  . Рост
. Рост  на 5-10% сверх
на 5-10% сверх  приводит к увеличению
приводит к увеличению  и росту
и росту  на порядок.
на порядок.
Вторая фаза – область переноса паров. Распространение атомарно-молекулярного потока от источника пара к подложке осуществляется путём диффузионного и конвективного массопереноса на который влияет степень вакуума. Для получения пленок с наименьшим содержанием примесей необходимо, чтобы атомы и молекулы пара двигались к подложкам без столкновений с молекулами остаточного газа, т.е. прямолинейно. Это возможно, если длина свободного пробега частиц пара  будет больше расстояния "источник-подложка".
будет больше расстояния "источник-подложка".
Из кинетической теории газов известно, что:
 ;
;  , поэтому
, поэтому  , (3.3)
, (3.3)
где  - эффективный диаметр молекул;
- эффективный диаметр молекул;
"Докажите, что при n испытаниях по схеме Бернулли вероятность Pnm того, что ровно m из них будут успешными, определяется равенством" - тут тоже много полезного для Вас.
 - концентрация молекул при данном
- концентрация молекул при данном  и
и  ,
,  .
.
Начиная с давления p = 10-2 Па 
 становится намного больше расстояния "подложка-источник" и вероятность столкновений в пролетном пространстве с молекулами остаточного газа крайне низка.
становится намного больше расстояния "подложка-источник" и вероятность столкновений в пролетном пространстве с молекулами остаточного газа крайне низка.
Третья фаза - процесс конденсации паров. Процесс конденсации зависит от температуры подложки. При этом могут происходить три явления: адсорбция, приводящая к окончательному осаждению атома; адсорбция, приводящая к реиспарению через некоторое время; отражение сразу же после удара. Отражение обычно имеет наибольшую вероятность. Согласно теории конденсации, электрически нейтральные частицы пара при приближении к поверхности конденсации попадают в поле сил притяжения. На очень близком расстоянии на конденсирующуюся частицу действуют силы отталкивания.
Конденсация атомов происходит при условии, если их энергия связи с атомами подложки больше средней энергии атомов подложки, в противном случае атомы отражаются от подложки.
Температура, выше которой все атомы отражаются от подложки и пленка не образуется, называется критической температурой конденсации. Она зависит от материалов пленки и подложки и от состояния поверхности последней.
Образование зародышей происходит в результате нахождения атомами мест, соответствующих минимуму свободной энергии системы "атом-подложка". Рост зародышей происходит за счет присоединения новых атомов из парового потока или мигрирующих по подложке. По мере конденсации пара зародыши растут, между ними образуются соединительные мостики, зародыши сливаются в крупные островки. После этого наступает стадия слияния островков с образованием сетчатой структуры пленки. Сетчатая структура переходит в сплошную пленку, которая начинает расти в толщину. На этапе образования зародышей воздействие остаточных газов на пленку должно быть сведено к минимуму. Это обеспечивается или повышением степени вакуума или увеличением скорости парообразования.
Рекомендуемые лекции
- Докажите, что при n испытаниях по схеме Бернулли вероятность Pnm того, что ровно m из них будут успешными, определяется равенством
- Формирование и обеспечение комплексной защищенности информационных ресурсов
- 8 О корпоративном строительстве
- 8. Тема Ватерлоо у Стендаля и Теккерея
- 37 Личные неимущественные права детей





















