Основы ионного легирования
5. Основы ионного легирования
Интенсивная разработка метода ионного легирования (ионной имплантации) полупроводников началась как в нашей стране, так и за рубежом в начале 60-х годов.
Интерес к методу ионного легирования (ионно-лучевого легирования) вызван тем, что он обладает рядом существенных преимуществ по сравнению с традиционно существующими – диффузией, вплавлением и легированием из расплава.
Сравнительно низкая температура обработки полупроводниковых подложек, точный контроль глубины и профиля распределения примеси, гибкость и универсальность, возможность полной автоматизации – основные достоинства метода.
5.1. Понятие о технологии ионного легирования
Ускоренный ион, внедряясь в полупроводниковую пластину, являющуюся мишенью, теряет энергию и производит так называемое ионное легирование. Это явление можно рассматривать как рассеяние падающих ионов на отдельных атомах, образующих твердое вещество.
Процесс ионного легирования зависит от:
1) скорости ионов,
2) массы ионов,
3) материала мишени,
4) ориентации пучка.
Рекомендуемые материалы
Так как при этом ионы пучка и кристаллической решетки взаимодействуют, возникает ряд интересных явлений.
На рисунке приведена схема распределения внедренных ионов в кристалле.

А – область, в которой распределение имеет такой же вид, как и в аморфной мишени.
Б – область деканалирования.
В – распределение атомов, создаваемое каналированием.
Внедряя ионы III и V групп в монокристалл кремния можно получить p-n-переход в любом месте, на любой площади. Для аморфных тел глубина внедрения ионов пропорциональна ускоряющему напряжении, и ее можно регулировать, изменяя энергию падающих ионов. Используя ионы высокой энергии в результате их глубокого проникновения в кремний n-типа можно получить скрытую область p-типа и, наоборот в p-кремнии создать скрытую область n-типа.
Низкая энергия Высокая энергия

Переход, образованный в результате ионного легирования.
Основное преимущество метода ионного легирования перед диффузией – это свобода выбора легирующей примеси независимо от вида полупроводникового материала, так как при ионном легировании нет необходимости учитывать степень растворимости примесей и коэффициент диффузии.
5.2. Оборудование для ионного легирования
Возможности методов диффузии оказались ограниченными при миниатюризации приборов и повышение точности определения количества вводимых примесей. По методу ионного легирования введение примесей в полупроводник осуществляется за счет кинетической энергии ионов примеси, и их количество может быть точно определено электрическими методами.
Конструктивная схема установки ионного легирования:

Наиболее типичными являются:
1. высококачественный ионный источник;
2. ионный источник с электронной бомбардировкой;
3. ионный источник питания;
4. уроплазмотрон.
Движение электронов в магнитном поле описывается системой уравнений в ортогональных координатах:



где e – заряд электрона;
m – масса заряженной частицы;
B – напряженность магнитного поля.
Электроны и ионы совершают вращательное движение в соответствии с этим уравнением.
5.3. Длина пробега ионов
Распределение внедренных ионов по глубине распределяется:
1) величиной ускоряющего напряжения;
2) направлением движения ионов относительно мишени;
3) температурой мишени при внедрении;
4) температурой последующей термообработки.
Внедряемые ионы при многократном столкновении с атомами мишени постоянно теряют свою первоначальную энергию и останавливаются.
Рассмотрим случай, когда мишень является аморфной. Внедряемые в мишень ионы, двигаясь, меняют направление своего движения из-за столкновений с атомами мишени. В свою очередь атомы мишени в результате столкновений могут приобрести энергию, достаточную для движения в твердом теле (рис.).

В результате вдоль траектории внедренных ионов образуется многочисленное число вакансий и между узловых атомов. Если процесс происходит в кристаллическом поле, то в результате больших искажений его кристаллической решетки может произойти аморфизация решетки такого тела.
Расстояния, проходимые внедренными атомами до остановки, имеют определенные, но различные для каждого вида ионов значения. Теория вероятности позволяет их вычислить.
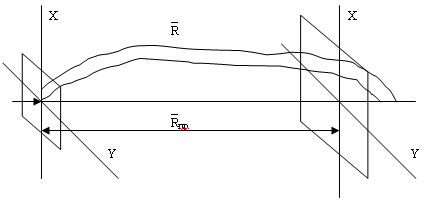
Длинна пробега внедренных ионов:
R - полная длинна пробега;
Rпр – проекция полной длинны пробега.
К механизмам потери энергии внедряемыми ионами можно отнести взаимодействие между внедряемыми ионами и электронами мишени (неупругие столкновения), а также упругие столкновения внедряемых ионов с ядрами атомов мишени. Если энергия ионов относительно мала, они теряют ее при упругом столкновении с ядрами мишени, а если энергия велика – при взаимодействии с электронами. С увеличением массы внедряемых ионов потери энергии за счет столкновений с ядрами возрастают.
Для определения длинны пробега внедряемых ионов будем считать, что эти механизмы потери энергии действуют одновременно и повсеместно. Средняя величина энергии, теряемой на единице длинны пробега внедряемого иона:
 , (1)
, (1)
где N – среднее количество атомов в единице объема мишени;
Sn(E) – ядерная тормозная способность;
Se(E) – электронная тормозная способность.
Средняя полная длинна пробега R для ионов с энергией Ei определяется интегрированием (1):
 . (2)
. (2)
Поскольку при определении длинны пробега таким методом пренебрегают погрешностью в энергии, теряемой на расстоянии dx, и учитывают лишь среднюю величину, определение длинны пробега действительно лишь в первом приближении.
Если известны значения Sn(E) и Se(E), то по формуле (2) можно определить R (полную среднюю длину пробега). Величиной, определяемой экспериментально, является проекция пробега на направление первичного ионного пучка.
Закон распределения концентрации ионов, внедрившихся в полупроводник, записывается в виде:
 ,
,
где Q – поверхностная плотность внедряемых примесных ионов, определяемая дозой облучения D=qlQ (l – целое число, соответствующее заряду иона).
Максимальную концентрацию внедряемых ионов определяют по выражению:

Графики распределения внедренных ионов обычно строят в относительных единицах (N(a)/Nmax). При ионном легировании максимальное значение концентрации Nmax наблюдается на некотором удалении от поверхности, зависящем от энергии ионов, при этом чем больше энергия, тем глубже располагается максимум концентрации внедряемых ионов.
При внедрении ионов акцепторной примеси коэффициент использования вводимых ионов определяется по формуле:
 ,
,
где p – средняя концентрация дырок в легированном слое, NД – средняя концентрация внедренных атомов акцепторной примеси.
5.4. Монокристалл
Если посмотреть на монокристалл вдоль определенного кристаллографического направления, то можно увидеть, что атомы полностью упорядочены и в кристалле имеются окна. Если проводить ионное легирование в таком направлении, то ионы могут внедряться довольно глубоко, не сталкиваясь с атомами мишени. Такое явление называется каналированием.
На практике наиболее распространенными методами определения распределения внедренных примесей являются:
1) метод радиоактивных изотопов;
2) метод измерения дифференциальной проводимости;
3) метод измерения дифференциальной проводимости с помощью эффекта Холла;
4) метод, основанный на определении глубины значения p-n-перехода.
При ионном легировании элементарных полупроводников внедренные ионы оказывают сильное влияние на изменение электрических характеристик. При ионном легировании сложных полупроводников большое влияние на электрические характеристики кристаллов оказывает нарушение стехиометрии.
Ионное легирование сложных полупроводников является интересной проблемой. Однако в связи с исключительной сложностью явлений, возникающих в них при ионном легировании, в настоящее время не проведено глубоких исследований по этому вопросу. Вопрос находится в стадии изучения.
5.6. Синтез веществ с помощью ионного легирования
При легировании GaAs ионами P и Al можно получить сложные соединения типа GaAsP и GaAlAs. GaAs – это основной материал фотодиодов. Для того чтобы спектр излучения сместить в видимую область необходимо использовать GaAsP, являющийся сложным кристаллическим веществом состоящим GaAs и GaP или GaAlAs, состоящий из GaAs и AlAs. На рисунке показана зависимость ширины запрещенной зоны от концентрации фосфора (x) в GaAs1-xPx.
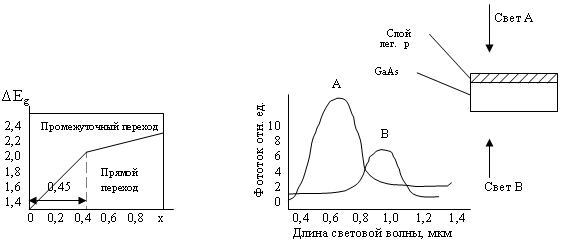
Если после образования соединения GaAsP образец облучать светом со стороны легированного P слоя, то максимальный фототок будет при длине волны света 0,65 мкм, при облучении с обратной стороны максимальный фототок наблюдается при длине волны 0,89 мкм.
5.7. Отжиг легированных слоев
Если в полупроводниковый материал, например кремний, вести донорную примесь (фосфор), то получается полупроводник n-типа (КЭФ) (КДБ). Однако полное легирование отличается от диффузии тем, что при обычном внедрении примесей получить полупроводник n-типа нельзя. Для этого необходима после легирования соответствующая термообработка, вызванная двумя причинами:
Если Вам понравилась эта лекция, то понравится и эта - Свойства и структура сознания.
1. Необходимо восстановить упорядоченное расположение атомов в кристалле, которое было нарушено при легировании ионами высокой энергии.
2. При ионном легировании внедряемые ионы кроме положений замещения могут занимать и междуузельные положения в кристаллической решетке.
В междоузлии примесь находится в нестабильном положении. Местоположение энергетических уровней атомов, находящихся в междоузлии пока не известно. Однако установлено, что донорные уровни, как это имеет место в случае атомов замещения, для атомов в междоузлиях – отсутствуют. Перемещение атомов из междоузлий в положение замещения достигается термообработкой.
На рисунке приведены данные процентного содержания примесных атомов замещения и в междоузлиях в зависимости от температуры подложки при легировании кремния сурьмой Sb.

Если температуру подложки повысить во время легирования Sb до 300 oC, то почти все ее атомы перейдут в положение замещения. Следовательно, в кристалле образуются донорные уровни, что приводит к инверсии типа проводимости легированного слоя из p-типа в n-тип. В настоящее время ведутся интенсивные исследования процессов ионного легирования.



















